사업소개
미래지향적인 기술력으로 끊임없이 도전하는 기업
단결정 장비 사업부 (EPICA)
EPICA- Advanced HVPE System
Technology Introduction
EPICA – GaN Template Mass Production System
EPICA – 2 Stack System
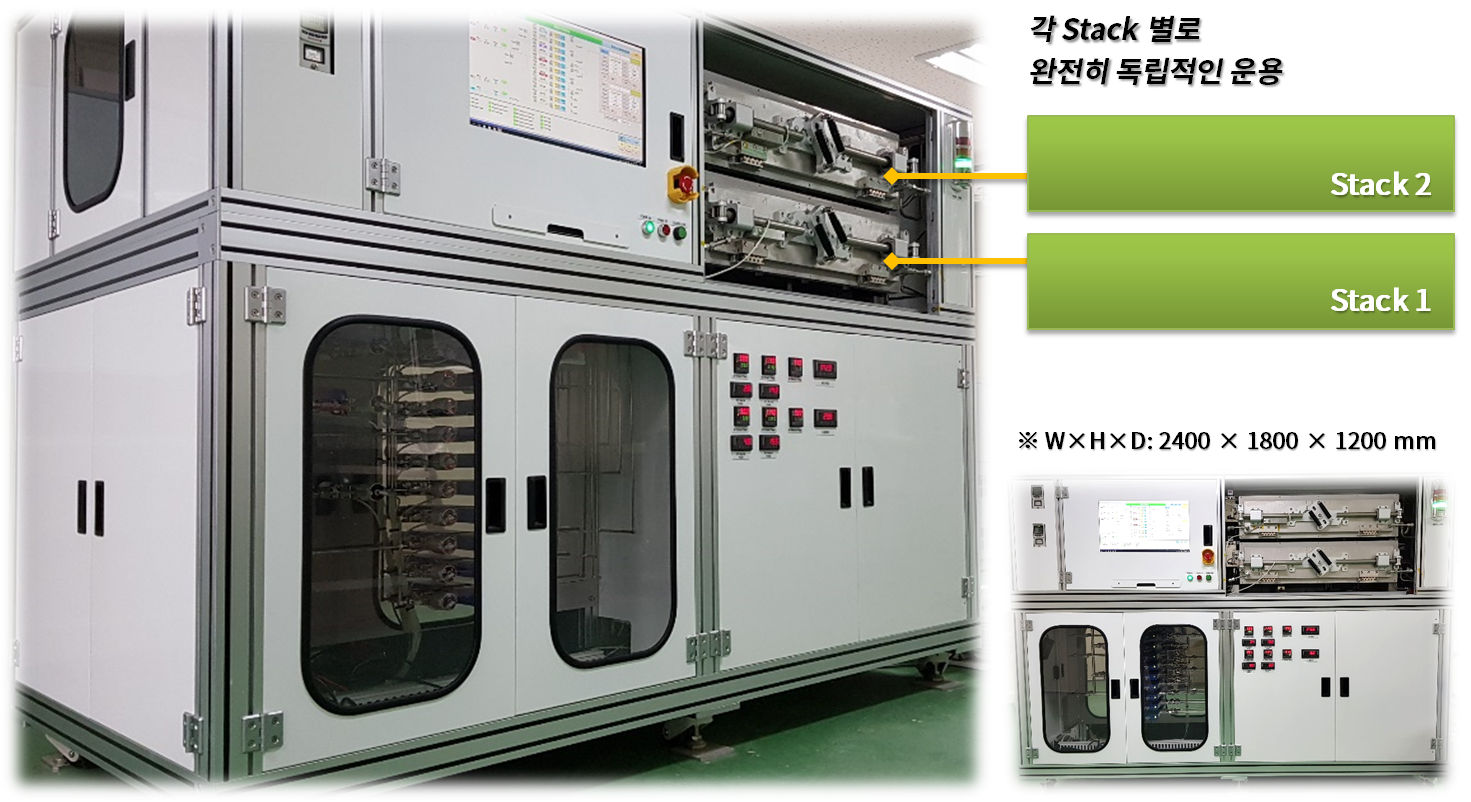
Comparison of Conventional HVPEs and EPICA
| 구분 | Conventional HVPE | CVD Based HVPE | EPICA HVPE |
|---|---|---|---|
| 장비의 기본 형태 |
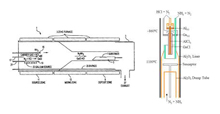
Horizontal or Vertical Type |

|
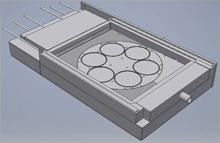
Multi-Stacked Extendable |
| 특징 |
|
|
|
| 용량 | ≤ 4 inch × 3ea / ≤ 6 inch × 1ea | 4 inch × 9ea / 6 inch × 4ea | 4 inch × 6ea / 6 inch × 3ea (@ One Unit Reactor) |
| 최대 성장률 | ≤ 150 ㎛/h (Horizontal) ≤ 300 ㎛/h (Vertical) |
≤ 30 ㎛/h | ≤ 120 ㎛/h |
| 20 ㎛ target 표준 공정 시간 |
≥ 150 min (지속적인 Heater 가동 및 Cleaning 공정 포함) |
≤ 180 min (추정) | ≤ 200 min (Reactor 승온, 냉각 시간 포함) |
| H2 gas 사용 및 압력 control |
Not available (or Dangerous) | Available (추정) | Available |
| System 운용 비용 | Relatively Mid. cost | Relatively High cost (from Initial Process) |
Relatively Low cost |
Performance - GaN on 4 inch NSS
NSS

Thickness STD: 2.72 % @ 5.51 ㎛

XRC ω-scan
(002) 309.6 arcsec
(102) 370.8 arcsec
Under developing for high quality
Performance – GaN on 4 inch AlN Sputtered PSS

PSS Cone: 1.75 × 2.75 ㎛
AlN 30 nm By Sputter
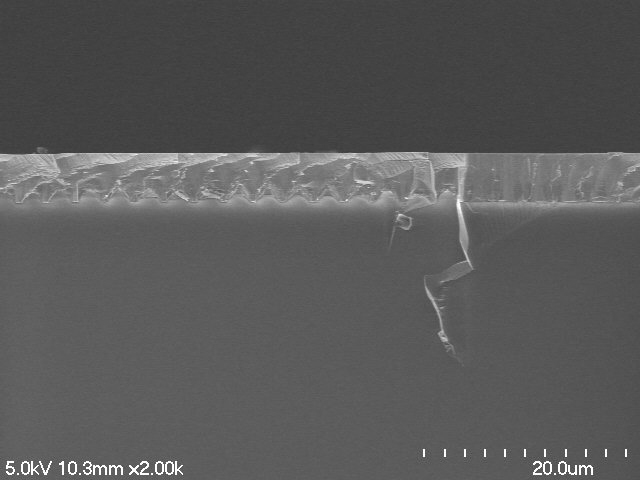
GaN Thickness: 4.82 ㎛
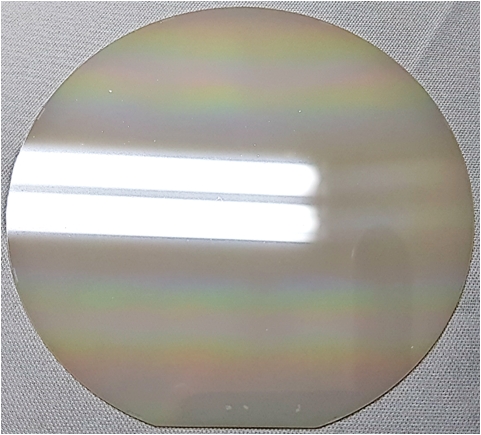
XRC ω-scan
(002) 158.4 arcsec
(102) 219.6 arcsec
Under developing for high quality
Performance – GaN on 6 inch AlN Sputtered PSS

XRC ω-scan
(002) 179 arcsec
(102) 268 arcsec
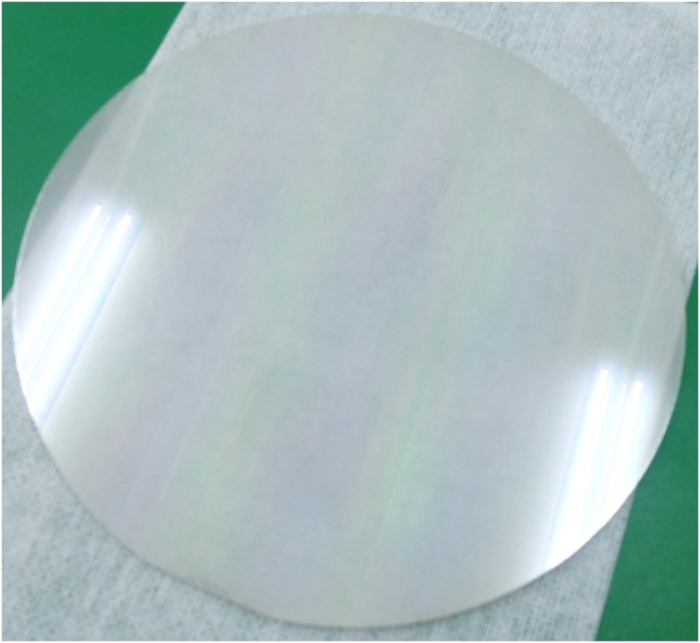

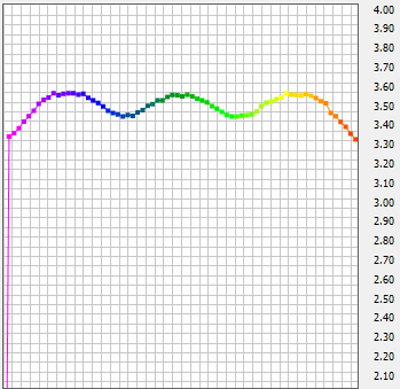
Thickness STD: 2.32 % @ 3.45 ㎛
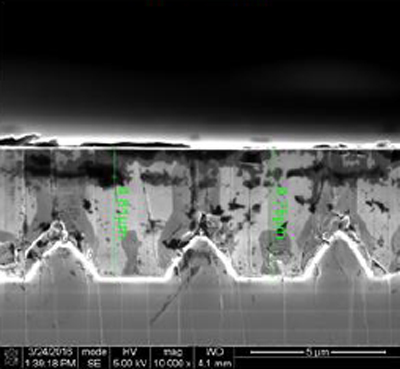
Cross-section
System Specification Chart
| Division | Item | Unit | Specification | |
|---|---|---|---|---|
| Hardware | Reactor Type | - | Multi-Stacked Structure of Unit Reactor (SUS Chamber) | |
| Dimension | [mm] | About < 900 × < 700 × < 200 (Unit Reactor) | ||
| Capacity | 2 inch [ea] | 21 / Reactor | The number of Reactors (stack) is determined by the customer’s requirements. | |
| 4 inch [ea] | 6 / Reactor | |||
| 6 inch [ea] | 3 / Reactor | |||
| Process Run time | [min] | ~ 210 (Manual loading, ~ 10 ㎛ target) | ||
| Max. Temperature | [℃] | 1,150 (@ Heater Zone) | ||
| Temp. Ramping rate | [℃/min] | ~ 50 (≤ 800 ℃ Heating), ~ 10 (Avg. Cooling) | ||
| Rotation speed | [RPM] | About 15 | ||
| Process | Growth rate | [㎛/hr] | 2 ~ 120 | |
| WIW, WTW thickness STD | % | ≤ 2 | ||
| WIW, WTW sheet resistance STD | % | ≤ 2 | ||
| Doping range | [ N / ㎤] | 5 × 1017 ~ 2 × 1019 | ||
| H2 carrier Gas | Option | Available (by the customer’s requirements) | ||
| Reactor Pressure Control | Option | Available (by the customer’s requirements) | ||
Intellectual Properties
| No. | 발명 명칭 | 국적 | 출원번호 | 등록여부 | 등록번호 |
|---|---|---|---|---|---|
| 1 | 웨이퍼 회전 장치 | 대한민국 | 10-2017-0036204 | 등록 | 10-1885026 |
| 2 | 화학기상증착용반응기 및 이를 포함하는 화학기상증착장치 | 대한민국 | 10-2017-0047089 | 등록 | 10-2008056 |
| 3 | 웨이퍼 회전 장치 | PCT | PCT/KR2018/002773 | 출원 완료 | - |
| 4 | 화학기상증착용반응기 및 이를 포함하는 화학기상증착장치 | PCT | PCT/KR2018/002774 | 출원 완료 | - |